IC封装图片大全


名词释义

COF(Chip On Flex,或Chip On Film,常称覆晶薄膜)
将IC固定于柔性线路板上晶粒软膜构装技术,是运用软质附加电路板作封装芯片载体将芯片与软性基板电路接合的技术。
COG(Chip on glass)
即芯片被直接绑定在玻璃上。这种方式可以大大减小整个LCD模块的体积,并且易于大批量生产,使用于消费类电子产品,如手机,PDA等。
DIP(dual in-line package)
双列直插式封装。插装型封装之一,引脚从封装两侧引出,封装材料有塑料和陶瓷两种。DIP 是最普及的插装型封装,应用范围包括标准逻辑IC,存贮器LSI,微机电路等。引脚中心距2.54mm,引脚数从6 到64。封装宽度通常为15.2mm。有的把宽度为7.52mm 和10.16mm 的封装分别称为skinny DIP 和slim DIP(窄体型DIP)。但多数情况下并不加区分, 只简单地统称为DIP。另外,用低熔点玻璃密封的陶瓷DIP 也称为cerdip。
PDIP
P-Plasti,表示塑料封装的记号。如PDIP 表示塑料DIP。
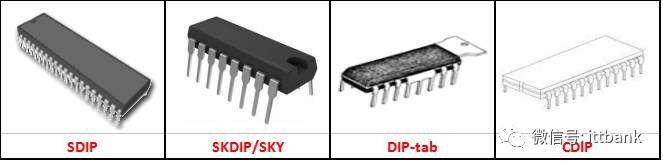
SDIP (shrink dual in-line package)
收缩型DIP。插装型封装之一,形状与DIP 相同,但引脚中心距(1.778mm)小于DIP(2.54mm),因而得此称呼。引脚数从14 到90。也有称为SH-DIP 的。材料有陶瓷和塑料两种。
SKDIP/SKY(Skinny Dual In-line Packages)
DIP 的一种。指宽度为7.62mm、引脚中心距为2.54mm 的窄体DIP。通常统称为DIP(见DIP)。
DIP-tab
DIP 的一种。
CDIP
C-ceramic,陶瓷封装的记号。例如,CDIP表示的是陶瓷DIP。是在实际中经常使用的记号。
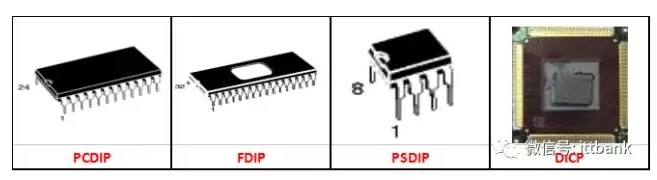
DICP(dualtapecarrierpackage)
双侧引脚带载封装。TCP(带载封装)之一。引脚制作在绝缘带上并从封装两侧引出。由于利用的是TAB(自动带载焊接)技术,封装外形非常薄。常用于液晶显示驱动LSI,但多数为定制品。另外,0.5mm厚的存储器LSI簿形封装正处于开发阶段。在日本,按照EIAJ(日本电子机械工业)会标准规定,将DICP命名为DTP。

DIC(dualin-lineceramicpackage)
陶瓷DIP(含玻璃密封)的别称。
SIP(single in-line package)
单列直插式封装。引脚从封装一个侧面引出,排列成一条直线。当装配到印刷基板上时封装呈侧立状。引脚中心距通常为2.54mm,引脚数从2 至23,多数为定制产品。封装的形状各异。也有的把形状与ZIP 相同的封装称为SIP。
SOP(Small Outline Packages)
小外形引脚封装。
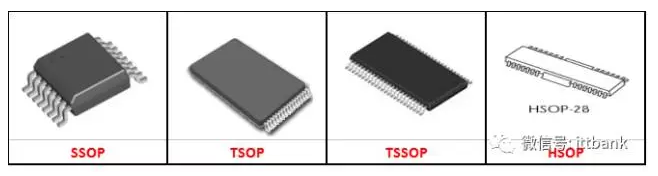
SSOP(Shrink Small-Outline Package)
窄间距小外型塑封装,1968~1969年飞利浦公司就开发出小外形封装(SOP)。
TSOP(Thin Small Outline Package)
意思是薄型小尺寸封装。TSOP内存是在芯片的周围做出引脚,采用SMT技术(表面安装技术)直接附着在PCB板的表面。
TSSOP(Thin Shrink Small Outline Package
薄的缩小型SOP。比SOP薄,引脚更密,相同功能的话封装尺寸更小。
HSOP(Head Sink Small Outline Packages)
H-(with heat sink),表示带散热器的标记。例如,HSOP 表示带散热器的SOP。
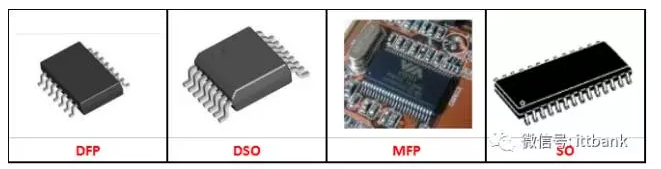
DFP(dual flat package)
双侧引脚扁平封装。是SOP 的别称(见SOP)。以前曾有此称法,现在已基本上不用。10、DIC(dual in-line ceramic package)陶瓷DIP(含玻璃密封)的别称(见DIP)。
DSO(dual small out-lint)
双侧引脚小外形封装。SOP 的别称(见SOP)。部分半导体厂家采用此名称。
MFP(mini flat package)
小形扁平封装。塑料SOP 或SSOP 的别称(见SOP 和SSOP)。部分半导体厂家采用的名称。
SO(small out-line)
SOP 的别称。世界上很多半导体厂家都采用此别称。(见SOP)。

SOIC(small out-line integrated circuit)
SOP 的别称(见SOP)。国外有许多半导体厂家采用此名称。
SOJ(Small Out-Line J-Leaded Package)
J 形引脚小外型封装。表面贴装型封装之一。引脚从封装两侧引出向下呈J 字形,故此得名。通常为塑料制品,多数用于DRAM 和SRAM 等存储器LSI 电路,但绝大部分是DRAM。用SOJ 封装的DRAM 器件很多都装配在SIMM 上。引脚中心距1.27mm,引脚数从20 至40(见SIMM)。
SOT(Small Outline Transistor)
小外型晶体管,SOP系列封装的一种。

TO(Transistor Outline)
晶体管封装。
QFP(quad flat package)
四侧引脚扁平封装。表面贴装型封装之一,引脚从四个侧面引出呈海鸥翼(L)型。基材有陶瓷、金属和塑料三种。从数量上看,塑料封装占绝大部分。当没有特别表示出材料时, 多数情况为塑料QFP。塑料QFP 是最普及的多引脚LSI 封装。不仅用于微处理器,门陈列等数字逻辑LSI 电路,而且也用于VTR 信号处理、音响信号处理等模拟LSI 电路。引脚中心距有1.0mm、0.8mm、0.65mm、0.5mm、0.4mm、0.3mm 等多种规格。0.65mm 中心距规格中最多引脚数为304。日本将引脚中心距小于0.65mm 的QFP 称为QFP(FP)。但现在日本电子机械工业会对QFP 的外形规格进行了重新评价。在引脚中心距上不加区别,而是根据封装本体厚度分为QFP(2.0mm~3.6mm 厚)、LQFP(1.4mm 厚)和TQFP(1.0mm 厚)三种。另外,有的LSI 厂家把引脚中心距为0.5mm 的QFP 专门称为收缩型QFP 或SQFP、VQFP。但有的厂家把引脚中心距为0.65mm 及0.4mm 的QFP 也称为SQFP,至使名称稍有一些混乱。QFP 的缺点是,当引脚中心距小于0.65mm 时,引脚容易弯曲。为了防止引脚变形,现已出现了几种改进的QFP 品种。如封装的四个角带有树指缓冲垫的BQFP(见BQFP);带树脂保护环覆盖引脚前端的GQFP(见GQFP);在封装本体里设置测试凸点、放在防止引脚变形的专用夹具里就可进行测试的TPQFP(见TPQFP)。在逻辑LSI 方面,不少开发品和高可靠品都封装在多层陶瓷QFP 里。引脚中心距最小为0.4mm、引脚数最多为348 的产品也已问世。此外,也有用玻璃密封的陶瓷QFP(见Gerqa d)。
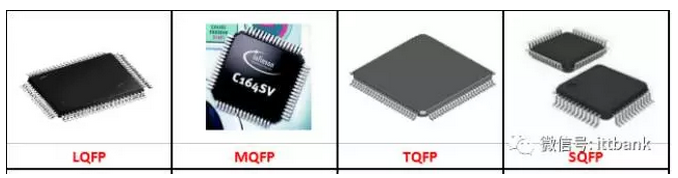
LQFP(low profile quad flat package)
薄型QFP。指封装本体厚度为1.4mm 的QFP,是日本电子机械工业会根据制定的新QFP 外形规格所用的名称。
MQFP(metric quad flat package)
按照JEDEC(美国联合电子设备委员会)标准对QFP 进行的一种分类。指引脚中心距为0.65mm、本体厚度为3.8mm~2.0mm 的标准QFP(见QFP)。
TQFP(Thin Quad FLat Packages)
薄塑封四角扁平封装。
SQFP(Shorten Quad FLat Packages)
缩小型细引脚间距QFP。
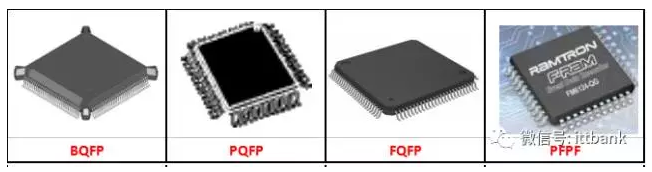
BQFP(quad flat package with bumper)
带缓冲垫的四侧引脚扁平封装。QFP 封装之一,在封装本体的四个角设置突起(缓冲垫) 以防止在运送过程中引脚发生弯曲变形。美国半导体厂家主要在微处理器和ASIC 等电路中采用此封装。引脚中心距0.635mm,引脚数从84 到196 左右。
PQFP(PlasticQuadFlatPackage)
塑料四边引出扁平封装。
FQFP(fine pitch quad flat package)
小引脚中心距QFP。通常指引脚中心距小于0.65mm 的QFP(见QFP)。部分导导体厂家采用此名称。
PFPF(plastic flat package)
塑料扁平封装。塑料QFP 的别称(见QFP)。部分LSI 厂家采用的名称。
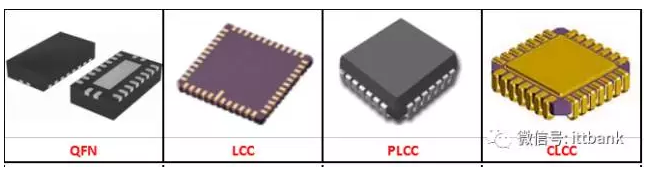
QFN(quad flat non-leaded package)
四侧无引脚扁平封装。表面贴装型封装之一。现在多称为LCC。QFN 是日本电子机械工业会规定的名称。封装四侧配置有电极触点,由于无引脚,贴装占有面积比QFP 小,高度比QFP 低。但是,当印刷基板与封装之间产生应力时,在电极接触处就不能得到缓解。因此电极触点难于作到QFP 的引脚那样多,一般从14 到100 左右。材料有陶瓷和塑料两种。当有LCC 标记时基本上都是陶瓷QFN。电极触点中心距1.27mm。塑料QFN 是以玻璃环氧树脂印刷基板基材的一种低成本封装。电极触点中心距除1.27mm 外,还有0.65mm 和0.5mm 两种。这种封装也称为塑料LCC、PCLC、P-LCC 等。
LCC(Leadless chip carrier)
无引脚芯片载体。指陶瓷基板的四个侧面只有电极接触而无引脚的表面贴装型封装。是高速和高频IC 用封装,也称为陶瓷QFN 或QFN-C(见QFN)。
PLCC(plastic leaded chip carrier)
带引线的塑料芯片载体。表面贴装型封装之一。引脚从封装的四个侧面引出,呈丁字形, 是塑料制品。美国德克萨斯仪器公司首先在64k 位DRAM 和256kDRAM 中采用,现在已经普及用于逻辑LSI、DLD(或程逻辑器件)等电路。引脚中心距1.27mm,引脚数从18 到84。J 形引脚不易变形,比QFP 容易操作,但焊接后的外观检查较为困难。PLCC 与LCC(也称QFN)相似。以前,两者的区别仅在于前者用塑料,后者用陶瓷。但现在已经出现用陶瓷制作的J 形引脚封装和用塑料制作的无引脚封装(标记为塑料LCC、PC LP、P -LCC 等),已经无法分辨。为此,日本电子机械工业会于1988 年决定,把从四侧引出J 形引脚的封装称为QFJ,把在四侧带有电极凸点的封装称为QFN(见QFJ 和QFN)。
CLCC(ceramic leaded chip carrier)
带引脚的陶瓷芯片载体,表面贴装型封装之一,引脚从封装的四个侧面引出,呈丁字形。带有窗口的用于封装紫外线擦除型EPROM 以及带有EPROM 的微机电路等。此封装也称为QFJ、QFJ-G。
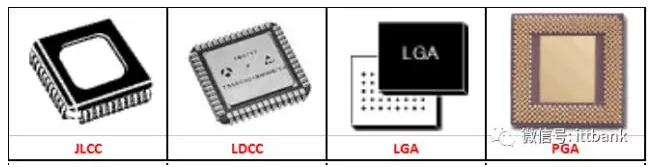
JLCC(J-leaded chip carrier)
J 形引脚芯片载体。指带窗口CLCC 和带窗口的陶瓷QFJ 的别称(见CLCC 和QFJ)。部分半导体厂家采用的名称。
LGA(land grid array)
触点陈列封装。即在底面制作有阵列状态坦电极触点的封装。装配时插入插座即可。现已实用的有227 触点(1.27mm 中心距)和447 触点(2.54mm 中心距)的陶瓷LGA,应用于高速逻辑LSI 电路。LGA 与QFP 相比,能够以比较小的封装容纳更多的输入输出引脚。另外,由于引线的阻抗小,对于高速LSI 是很适用的。但由于插座制作复杂,成本高,现在基本上不怎么使用。预计今后对其需求会有所增加。
PGA(pin grid array)
陈列引脚封装。插装型封装之一,其底面的垂直引脚呈陈列状排列。封装基材基本上都采用多层陶瓷基板。在未专门表示出材料名称的情况下,多数为陶瓷PGA,用于高速大规模逻辑LSI电路。成本较高。引脚中心距通常为2.54mm,引脚数从64 到447 左右。了为降低成本,封装基材可用玻璃环氧树脂印刷基板代替。也有64~256 引脚的塑料PG A。另外,还有一种引脚中心距为1.27mm 的短引脚表面贴装型PGA(碰焊PGA)。(见表面贴装型PGA)。
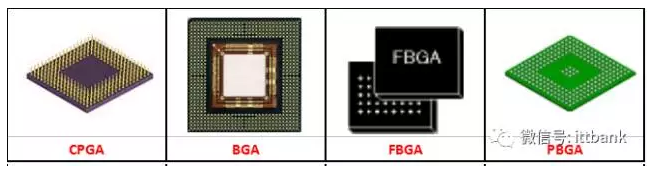
CPGA(Ceramic Pin Grid Array)
陶瓷针栅阵列封装。
BGA(ball grid array)
球形触点陈列,表面贴装型封装之一。在印刷基板的背面按陈列方式制作出球形凸点用以代替引脚,在印刷基板的正面装配LSI 芯片,然后用模压树脂或灌封方法进行密封。也称为凸点陈列载体(PAC)。引脚可超过200,是多引脚LSI 用的一种封装。封装本体也可做得比QFP(四侧引脚扁平封装)小。例如,引脚中心距为1.5mm 的360 引脚BGA 仅为31mm 见方;而引脚中心距为0.5mm 的304 引脚QFP 为40mm 见方。而且BGA 不用担心QFP 那样的引脚变形问题。
该封装是美国Motorola 公司开发的,首先在便携式电话等设备中被采用,今后在美国有可能在个人计算机中普及。最初,BGA 的引脚(凸点)中心距为1.5mm,引脚数为225。现在也有一些LSI厂家正在开发500 引脚的BGA。BGA 的问题是回流焊后的外观检查。现在尚不清楚是否有效的外观检查方法。有的认为,由于焊接的中心距较大,连接可以看作是稳定的,只能通过功能检查来处理。美国Motorola 公司把用模压树脂密封的封装称为OMPAC,而把灌封方法密封的封装称为GPAC(见OMPAC 和GPAC)。
FBGA(Fine-Pitch Ball Grid Array)
细间距球栅阵列。
PBGA(Plastic Ball Grid Array)
塑料焊球阵列封装。
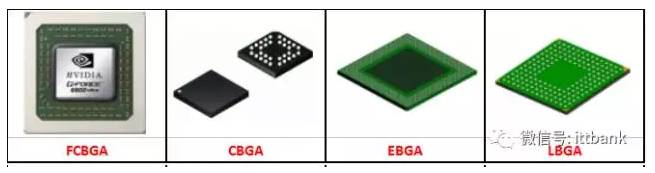
FCBGA(Flip Chip Ball Grid Array)
倒装芯片球栅格阵列。
CBGA
C-ceramic,陶瓷封装的记号。陶瓷焊球阵列封装。
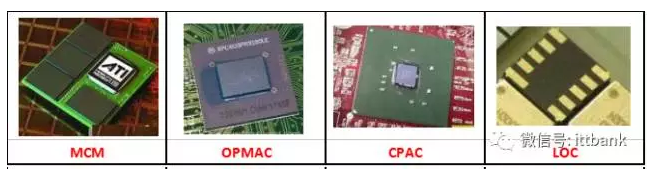
MCM(multi-chip module)
多芯片组件。将多块半导体裸芯片组装在一块布线基板上的一种封装。根据基板材料可分为MCM-L,MCM-C 和MCM-D 三大类。MCM-L 是使用通常的玻璃环氧树脂多层印刷基板的组件。布线密度不怎么高,成本较低。MCM-C 是用厚膜技术形成多层布线,以陶瓷(氧化铝或玻璃陶瓷)作为基板的组件,与使用多层陶瓷基板的厚膜混合IC 类似。两者无明显差别。布线密度高于MCM-L。
MCM-D 是用薄膜技术形成多层布线,以陶瓷(氧化铝或氮化铝)或Si、Al 作为基板的组件。布线密谋在三种组件中是最高的,但成本也高。
OPMAC(over molded pad array carrier)
模压树脂密封凸点陈列载体。美国Motorola 公司对模压树脂密封BGA 采用的名称(见BGA)。
CPAC(globe top pad array carrier)
美国Motorola 公司对BGA 的别称(见BGA)。
LOC(lead on chip)
芯片上引线封装。LSI 封装技术之一,引线框架的前端处于芯片上方的一种结构,芯片的中心附近制作有凸焊点,用引线缝合进行电气连接。与原来把引线框架布置在芯片侧面附近的结构相比,在相同大小的封装中容纳的芯片达1mm 左右宽度。
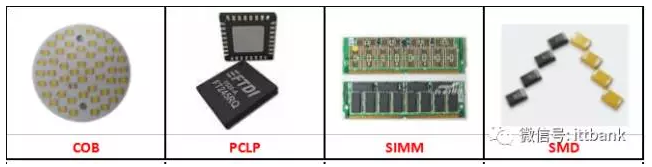
COB(chip on board)
板上芯片封装,是裸芯片贴装技术之一,半导体芯片交接贴装在印刷线路板上,芯片与基板的电气连接用引线缝合方法实现,芯片与基板的电气连接用引线缝合方法实现,并用树脂覆盖以确保可靠性。虽然COB 是最简单的裸芯片贴装技术,但它的封装密度远不如TAB 和倒片焊技术。
PCLP(printed circuit board leadless package)
印刷电路板无引线封装。日本富士通公司对塑料QFN(塑料LCC)采用的名称(见QFN)。引脚中心距有0.55mm 和0.4mm 两种规格。目前正处于开发阶段。
SIMM(single in-line memory module)
单列存贮器组件。只在印刷基板的一个侧面附近配有电极的存贮器组件。通常指插入插座的组件。标准SIMM 有中心距为2.54mm 的30 电极和中心距为1.27mm 的72 电极两种规格。在印刷基板的单面或双面装有用SOJ 封装的1 兆位及4 兆位DRAM 的SIMM 已经在个人计算机、工作站等设备中获得广泛应用。至少有30~40%的DRAM 都装配在SIMM 里。
SMD(surface mount devices)
表面贴装器件。偶尔,有的半导体厂家把SOP 归为SMD(见SOP)。

QFJ(quad flat J-leaded package)
四侧J 形引脚扁平封装。表面贴装封装之一。引脚从封装四个侧面引出,向下呈J 字形。是日本电子机械工业会规定的名称。引脚中心距1.27mm。材料有塑料和陶瓷两种。塑料QFJ 多数情况称为PLCC(见PLCC),用于微机、门陈列、DRAM、ASSP、OTP 等电路。引脚数从18 至84。陶瓷QFJ 也称为CLCC、JLCC(见CLCC)。带窗口的封装用于紫外线擦除型EPROM 以及带有EPROM 的微机芯片电路。引脚数从32 至84。